照片显示了2023年7月位于亚利桑那州钱德勒的英特尔组装和测试技术开发工厂的玻璃基板测试单元。英特尔的先进封装技术在该公司的组装和测试技术开发工厂得以实现。(来源:英特尔公司)
英特尔展示了其下一代玻璃基板封装技术,该技术将取代现有的有机材料并提供更高的互连。
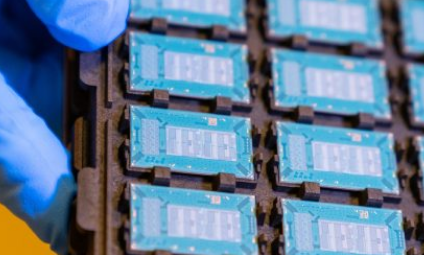
英特尔展示的技术是“玻璃基板”,它取代了目前现有芯片上使用的传统有机封装。在深入探讨该技术的工作原理之前,英特尔声称“玻璃基板”是未来的发展方向,而封装技术可以迅速实现行业内的大规模创新,尤其是HPC和AI,因为芯片封装已经最近成为城里的热门话题。
经过十年的研究,英特尔已经实现了行业领先的先进封装玻璃基板。我们期待提供这些尖端技术,使我们的主要参与者和代工客户在未来几十年受益。
2023年7月,在亚利桑那州钱德勒的英特尔组装和测试技术开发工厂,一名英特尔工程师拿着测试玻璃芯基板面板。英特尔的先进封装技术在该公司的组装和测试技术开发工厂得以实现。(来源:英特尔公司)
使特定芯片封装技术优越的关键因素是其能够在单个封装中集成尽可能多的“小芯片”。英特尔透露,借助玻璃基板,制造商现在可以采用“更大的小芯片复合体”,从而能够减少单个封装的占地面积,从而实现更高效、更增强的性能提升。
玻璃基板现在具有更高的耐温性和更扁平的设计,有助于层间连接。英特尔表示,玻璃基板的互连密度显着增加了10倍,从而实现无缝电力传输。
在上面的图片中,您可以看到上面演示芯片的边框部分具有类似玻璃的表面。通常,任何现代芯片的这个区域都将由有机材料组成,这就是当前芯片的制造方式。但借助玻璃基板,英特尔不仅可以使芯片变得更薄,还可以采用高达10倍的互连密度,从而实现先进的小芯片设计,这与我们所见过的任何设计都不同。由于使用了玻璃,英特尔将使用硅或硅,这已经是芯片开发的主要成分。
TeamBlue尚未指定“玻璃基板”的发布日期,但这使他们更接近到2030年封装“10亿个晶体管”的目标。玻璃基板将在HPC/AI行业中发挥最大的影响力。然而,下一个目标是该标准的实际采用,我们相信这将在未来几年内实现。
